图解AI芯片生态系統
2024-07-31
来源:芯智讯
随着众多厂商纷纷加大对于人工智能(AI)投资,推动了数据中心、HPC、自动驾驶等领域对于AI芯片需求的暴增。然而,一个AI芯片的诞生涵盖各个层面,包括芯片设计、制造到应用部署整个过程,并涉及多种技术和产业链。
目前英伟达(NVIDIA)、AMD、英特尔都极力开发AI芯片,英伟达推出最新GPU构架Blackwell,采用台积电定制化4nm制程制造;AMD则在今年COMPUTEX展示最新AI芯片MI325X,预计第四季上市;英特尔公布AI PC旗舰处理器Lunar Lake,采用台积电3nm技术,最快第三季登场。由于英伟达在AI芯片具有垄断地位,因此四大云端巨头Google、AWS、微软、Meta,都有推出或正在积极开发自研AI芯片。
近日,台媒Technews针对AI芯片生态系统还制作了一张图进行解析。
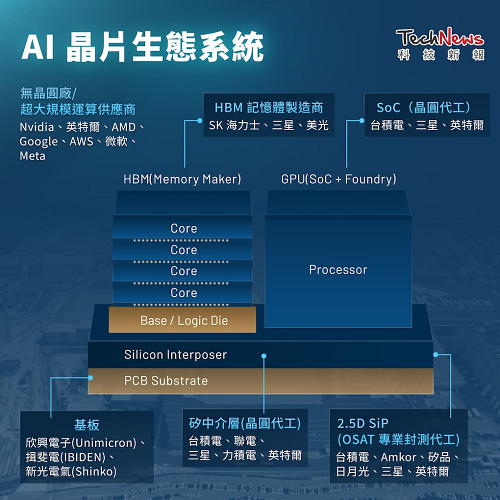
从目前的GPU AI芯片的结构来看,主要由HBM和GPU通过硅中介层堆叠在PCB基板上。HBM主要三大领导品牌分别为SK海力士、三星和美光,身为领导者的SK海力士目前向英伟达供应之前的8层HBM3E,但尚未收到12层版本的验证申请,预期现在目标是加快量产时间;至于三星HBM3E可望于第三季获得认证英伟达出货,仍要等待相关程序完成;美光则计划下半年完成12层HBM3E量产准备,明年供应给英伟达等主要客户。
韩媒指出,目前三大DRAM公司尚未决定向英伟达供应12层HBM3E,英伟达可能正在评估三家公司的出价,以满足需求并获取优惠的价格,下半年将是重要决胜时刻。
值得注意的是,当HBM堆叠层数越来越多,HBM封装厚度将受限于775微米(μm),因此混合键合(Hybrid Bonding)成为一项重要技术。目前SK海力士和三星表示会在未来HBM堆叠使用Hybrid Bonding,美光则表示还在研究中。
由于先进封装技术的高度复杂性,主要依赖三大晶圆厂台积电、三星和英特尔的代工服务。受益于AI热潮,导致台积电CoWoS产能持续紧张,联电与封测厂合作也分食到部分订单,力积电也将切入CoWoS硅中介层领域。专业封测代工厂部分,安靠(Amkor)去年第四季起逐步提供产能,日月光投控旗下矽品也于第一季时加入供应行列。
在高阶ABF载板部分,以欣兴电子、IBIDEN、SHINKO三间市占率合计超过八成。欣兴电子预期,随着AI在云端及边缘运算的应用扩大,高阶ABF载板将于2026年初再度供不应求。


