日立开发机器学习半导体缺陷检测技术
可检出10nm及更小微缺陷
2025-03-06
来源:IT之家
3月5日消息,日立当地时间2月27日称该企业已开发出了一种高灵敏度半导体缺陷检测技术,可通过机器学习的辅助检出10nm及更小尺寸的微缺陷。这项技术已在二月末的SPIE先进光刻与图案化2025学术会议上展出。
随着对高性能芯片的需求不断增加,半导体制造商对生产中的质量控制愈发重视;而制程的微缩也意味着能直接影响性能的缺陷尺寸门槛逐渐降低,对缺陷检测灵敏度的要求进一步提升。日立的这一技术就是在该背景下应运而生的。
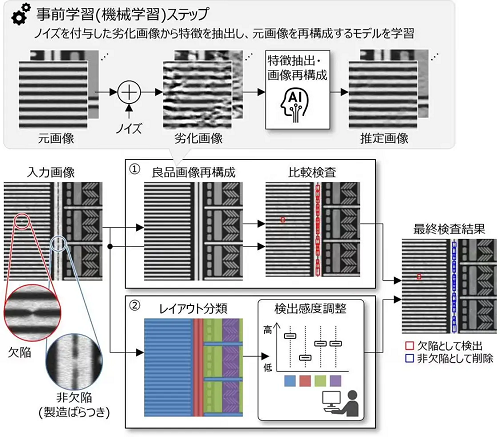
日立的机器学习缺陷检测技术主要包含两大部分,即图像重建对比和过度检测抑制:
图像重建对比:检测系统首先通过大量添加噪点的“人造”缺陷图像学习微缺陷的数据特征;实际使用时对扫描电镜照片尽量进行无缺陷版本重建,并对原始图像和重建图像进行对比,从而检出缺陷。
过度检测抑制:由于先进半导体制程的微缩,差异化功能电路和缺陷在图像上的区别逐渐模糊,而机器学习检测系统可对电路布局进行分类,并根据电路特征调整灵敏度,可减少90%的过度检测。

本站内容除特别声明的原创文章之外,转载内容只为传递更多信息,并不代表本网站赞同其观点。转载的所有的文章、图片、音/视频文件等资料的版权归版权所有权人所有。本站采用的非本站原创文章及图片等内容无法一一联系确认版权者。如涉及作品内容、版权和其它问题,请及时通过电子邮件或电话通知我们,以便迅速采取适当措施,避免给双方造成不必要的经济损失。联系电话:010-82306118;邮箱:aet@chinaaet.com。

