越来越多半导体企业布局200亿美元规模FCBGA封装市场
2024-09-05
来源:IT之家
9 月 5 日消息,集邦咨询 Trendforce 今天(9 月 5 日)发布博文,伴随着参与者越来越多,倒装芯片球栅阵列封装(FCBGA)基板行业正在蓬勃发展。
FCBGA 简介
FCBGA(Flip Chip Ball Grid Array,意为“倒装芯片球栅阵列封装”)是一种封装技术,这种封装方式将芯片倒置并连接到封装基板上,然后使用球形焊点将封装固定到基板上。
FCBGA 最早出现于 1990 年代初。1997 年,英特尔公司将 FCBGA 封装技术首次应用于处理器,这是 FCBGA 技术历史上的一个重要里程碑。
1999 年英特尔推出了第一款使用 FCBGA 封装技术的芯片,即 Pentium III 500 处理器。
FCBGA 封装技术的优点主要包括:
更高的密度:因为 FCBGA 封装技术可以在同样的封装面积内安装更多的芯片引脚,从而实现更高的集成度和更小的封装尺寸。
更好的散热性能:FCBGA 能允许芯片直接连接到散热器或散热片上,从而提高了热量传递的效率。
更高的可靠性和电性能:因为它可以减少芯片与基板之间的电阻和电容等因素,从而提高信号传输的稳定性和可靠性,也可以提高信号传输的速度和准确性。
FCBGA 封装技术具有高集成度、小尺寸、高性能、低功耗等优势,FCBGA 适用于多种种类的芯片,其常用于 CPU、微控制器和 GPU 等高性能芯片,还适用于网络芯片、通信芯片、存储芯片、数字信号处理器 (DSP)、传感器、音频处理器等等。
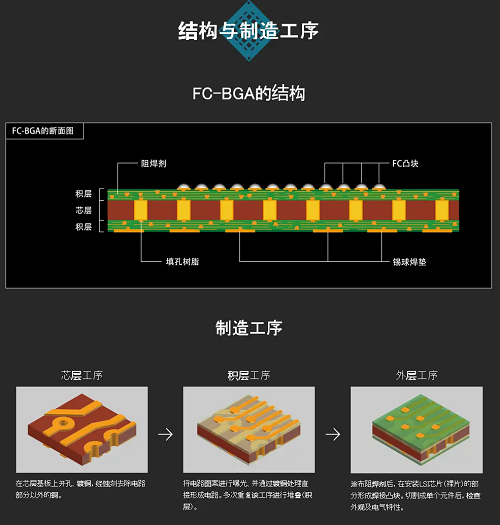
市场开始蓬勃发展
三星电机预估到 2026 年,其用于服务器和人工智能的高端倒装芯片球栅阵列(FCBGA)基板的销售份额将超过 50%。
集邦咨询认为经历了长期的库存削减之后,半导体供需双方的平衡得到了改善,市场需求逐渐恢复。
在全球范围内,美光(Micron)、英飞凌(Infineon)和恩智浦(NXP)等 IDM 公司在 FCBGA 封装领域进行了广泛的研究和开发,而 ASE Group、JCET 和 Amkor 等专业封装和测试公司也开发了各种 FCBGA 技术。
消息源表示包括英特尔、高通、英伟达、AMD 和三星在内的众多国际大型半导体公司都在使用 FCBGA 技术。
数据显示,未来几年全球 FCBGA 封装技术市场将继续快速增长,预计到 2026 年市场规模将超过 200 亿美元(IT之家备注:当前约 1423.94 亿元人民币)。
面对这样一个极具潜力的机遇,越来越多的企业开始加大力度开发 FCBGA 封装技术,不断促进其创新和升级。


